吴幸教授团队在GAAFET叠层结构可靠性研究中应变研究方面取得进展,研究成果以 “Direct Observation of Etching-Induced Inhomogeneous Strain in Advanced Si/SiGe Stack for Gate-All-Around Transistor”为题,发表于国际期刊 《Advanced Electronic Materials》。
环栅晶体管(GAAFET)因其优异的栅控能力和高驱动性能,是当前半导体领域的研究前沿。然而,在GAAFET制造过程中,Si/SiGe叠层的选择性刻蚀工艺会引入应变变化,影响沟道电流输运特性,其原子尺度下的应变分布规律尚不明确。针对这一挑战,华东师范大学通信与电子工程学院(集成电路科学与工程学院)吴幸教授团队及其合作者(包括华东师范大学李兰、李晓梅和北京大学毕然、黎明等)开展了系统研究。团队利用应变分析技术,研究了Si/SiGe堆叠结构在各向异性和各向同性刻蚀工艺下的应变演化,发现刻蚀速率在横向与纵向方向存在差异,导致SiGe层内部刻蚀深度与形貌不均。
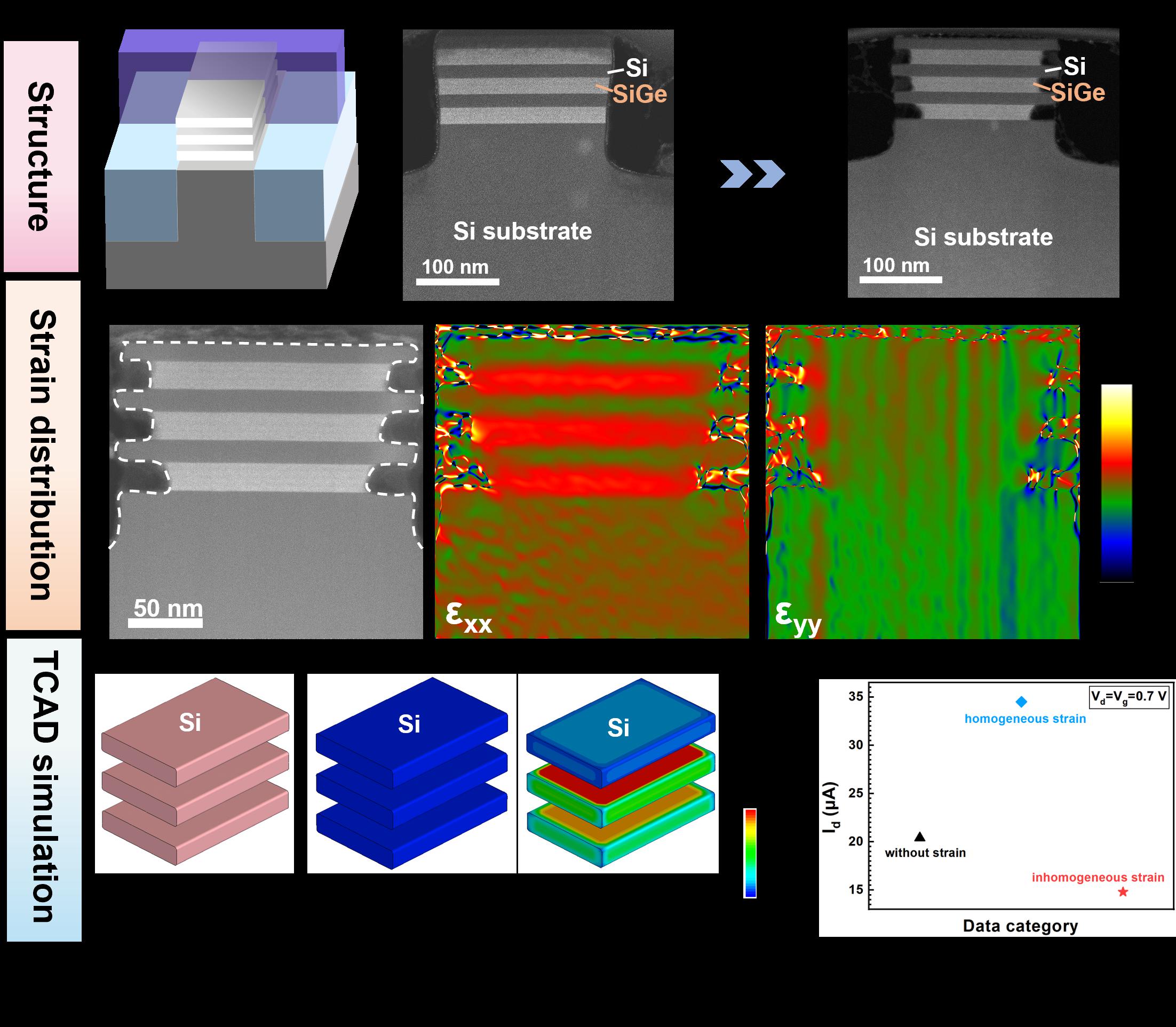
研究进一步通过原子级物理表征手段,直接观察到了叠层底部的应变集中现象。结合器件仿真,团队验证了这种非均匀应变对器件性能的影响。
吴幸教授团队一直致力于先进器件可靠性的研究,低温可靠性工作发表在2025年的集成电路三大顶会之一VLSI,高可靠芯片设计工作2025年发表于集成电路设计领域顶刊之一JSSC Vol 60, No. 3。未来,吴幸教授团队将继续深耕半导体器件可靠性研究,为突破芯片技术瓶颈、推动我国集成电路产业自主创新发展贡献华东师大智慧!

